Le verre devient rapidement unmatériel de plateformepour les marchés terminaux dirigés parcentres de donnéesettélécommunicationsAu sein des centres de données, il sous-tend deux supports d'emballage clés :architectures de pucesetentrée/sortie optique (E/S).
C'estfaible coefficient de dilatation thermique (CTE)etSupports en verre compatibles avec les ultraviolets profonds (DUV)ont activéliaison hybrideetTraitement de la face arrière des plaquettes minces de 300 mmpour devenir des flux de fabrication standardisés.
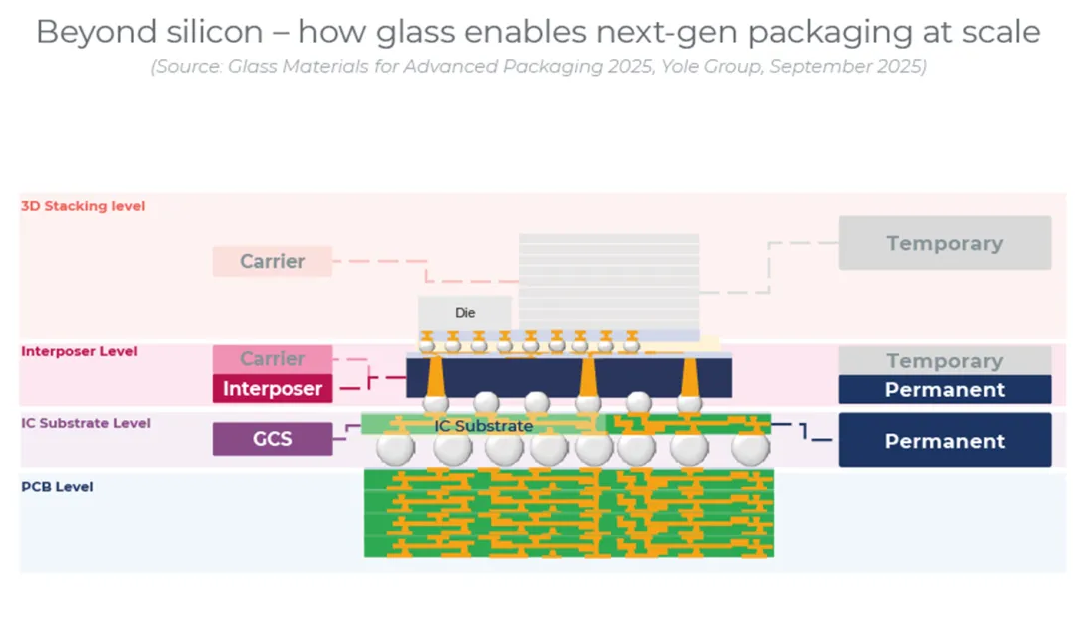
À mesure que les modules de commutation et d'accélération dépassent les dimensions des systèmes de lithographie par projection de plaquettes,porte-panneauxdeviennent indispensables. Le marché poursubstrats à noyau de verre (GCS)devrait atteindre460 millions de dollars d'ici 2030, avec des prévisions optimistes suggérant une adoption généralisée autour de2027–2028. Entre-temps,interposeurs en verredevraient dépasser400 millions de dollarsmême selon des projections prudentes, et lesegment porteur de verre stablereprésente un marché d'environ500 millions de dollars.
In emballage avancé, le verre est passé du statut de simple composant à celui deplateforme commerciale. Poursupports en verre, la génération de revenus évolue detarification par panneau to économie par cycle, où la rentabilité dépend decycles de réutilisation, rendements de décollage laser/UV, rendement du procédé, etatténuation des dommages aux bordsCette dynamique profite aux fournisseurs qui proposentportefeuilles classés CTE, fournisseurs de forfaitsvente de piles intégrées desupport + adhésif/LTHC + décollement, etfournisseurs régionaux de récupérationspécialisé dans l'assurance qualité optique.
Les entreprises possédant une expertise approfondie en matière de verre, telles quePlan Optik, connu pour sonsupports à haute planéitéavecgéométries de bord conçuesettransmission contrôlée—occupent une position optimale au sein de cette chaîne de valeur.
Les substrats à noyau de verre permettent désormais de rentabiliser les capacités de fabrication de panneaux d'affichage grâce àTGV (Through Glass Via), RDL (couche de redistribution) fine, etprocessus d'accumulationLes leaders du marché sont ceux qui maîtrisent les interfaces critiques :
-
Perçage/gravure TGV à haut rendement
-
Remplissage en cuivre sans vide
-
Lithographie sur panneau avec alignement adaptatif
-
2/2 µm L/S (ligne/espace)motifs
-
Technologies de manipulation de panneaux contrôlables par déformation
Les fournisseurs de substrats et d'OSAT qui collaborent avec les fabricants de verre pour écrans sont en train de se convertircapacité de grande surfacedansavantages économiques liés à l'emballage à l'échelle du panneau.

Du transporteur à la plateforme complète
Le verre s'est transformé d'untransporteur temporairedans unplateforme matérielle complètepouremballage avancé, s'alignant sur les mégatendances telles queintégration de chiplets, panélisation, empilement vertical, etliaison hybride— tout en réduisant simultanément les budgets pourmécanique, thermique, etsalle blancheperformance.
En tant quetransporteur(à la fois la plaquette et le panneau),verre transparent à faible coefficient de dilatation thermiquepermetalignement à contrainte minimaleetDécollement laser/UV, améliorant les rendements pourplaquettes de moins de 50 µm, Flux de processus arrière, etpanneaux reconstitués, permettant ainsi une rentabilité multi-usage.
En tant quesubstrat à noyau de verre, il remplace les noyaux organiques et les supportsfabrication au niveau des panneaux.
-
TGVassurer un routage vertical dense de l'alimentation et des signaux.
-
SAP RDLrepousse les limites du câblage à2/2 µm.
-
surfaces planes à coefficient de dilatation thermique ajustableminimiser la déformation.
-
transparence optiqueprépare le substrat pouroptiques co-emballées (CPO).
Entre-temps,dissipation de chaleurLes défis sont abordés par le biais deavions en cuivre, vias cousus, réseaux de distribution d'énergie arrière (BSPDN), etrefroidissement double face.
En tant queinterposeur en verre, le matériau réussit selon deux paradigmes distincts :
-
Mode passif, permettant des architectures massives d'IA/HPC et de commutation 2.5D qui atteignent une densité de câblage et un nombre de bosses inaccessibles par le silicium à un coût et une surface comparables.
-
Mode actif, intégrantSIW/filtres/antennesettranchées métallisées ou guides d'ondes gravés au laserau sein du substrat, repliement des chemins RF et acheminement des E/S optiques vers la périphérie avec une perte minimale.
Perspectives du marché et dynamique du secteur
Selon la dernière analyse deGroupe Yole, les matériaux en verre sont devenusau cœur de la révolution de l'encapsulation des semi-conducteurs, sous l'impulsion de grandes tendances dansintelligence artificielle (IA), calcul haute performance (HPC), connectivité 5G/6G, etoptiques co-emballées (CPO).
Les analystes soulignent que le verrepropriétés uniques—y compris sesfaible CTE, stabilité dimensionnelle supérieure, ettransparence optique—en faire un élément indispensable pour répondre aux besoinsexigences mécaniques, électriques et thermiquesdes emballages de nouvelle génération.
Yole note en outre quecentres de donnéesettélécommunicationsrestent lesmoteurs de croissance primairespour l'adoption du verre dans l'emballage, tandis queautomobile, défense, etélectronique grand public haut de gammecontribuer à un élan supplémentaire. Ces secteurs dépendent de plus en plus deintégration de chiplets, liaison hybride, etfabrication au niveau des panneaux, où le verre améliore non seulement les performances, mais réduit également le coût total.
Enfin, l'émergence denouvelles chaînes d'approvisionnement en Asie— particulièrement dansChine, Corée du Sud et Japon—est identifié comme un facteur clé pour accroître la production et renforcer leÉcosystème mondial pour le verre d'emballage avancé.
Date de publication : 23 octobre 2025
